삼성전자, 36GB HBM3E 12H D램 개발…상반기 양산 예정
전체 맥락을 이해하기 위해서는 본문 보기를 권장합니다.
삼성전자가 업계 최초로 36GB HBM3E 12H(12단 적층) D램 개발에 성공하고 고용량 HBM 시장 선점에 나선다.
삼성전자는 24Gb D램 칩을 TSV(실리콘 관통 전극) 기술로 12단까지 적층해 업계 최대 용량인 36GB HBM3E 12H를 구현했다고 27일 밝혔다.
이 글자크기로 변경됩니다.
(예시) 가장 빠른 뉴스가 있고 다양한 정보, 쌍방향 소통이 숨쉬는 다음뉴스를 만나보세요. 다음뉴스는 국내외 주요이슈와 실시간 속보, 문화생활 및 다양한 분야의 뉴스를 입체적으로 전달하고 있습니다.
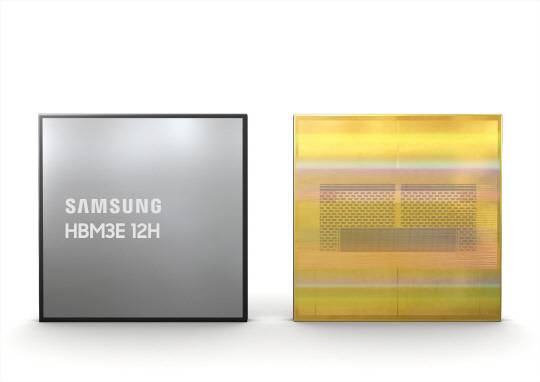
삼성전자가 업계 최초로 36GB HBM3E 12H(12단 적층) D램 개발에 성공하고 고용량 HBM 시장 선점에 나선다.
삼성전자는 24Gb D램 칩을 TSV(실리콘 관통 전극) 기술로 12단까지 적층해 업계 최대 용량인 36GB HBM3E 12H를 구현했다고 27일 밝혔다.
HBM3E 12H는 성능과 용량 측면에서 모두 전작인 HBM3 8H 대비 50% 이상 개선한 제품이다. 초당 최대 1280GB의 대역폭과 현존 최대 용량인 36GB를 제공한다.
삼성전자는 '어드밴스드 TC NCF'(열압착 비전도성 접착 필름) 기술로 12H 제품을 8H 제품과 동일한 높이로 구현해 HBM 패키지 규격을 만족시켰다.
어드밴스드 TC NCF 기술을 적용하면 HBM 적층수가 증가하고 칩 두께가 얇아지면서 발생할 수 있는 휘어짐 현상을 최소화할 수 있어 고단 적층 확장에 유리하다.
삼성전자는 NCF 소재 두께도 지속적으로 낮춰 업계 최소 칩간 간격인 '7㎛(마이크로미터)'를 구현했다. 이를 토대로 HBM3 8H 대비 20% 이상 향상된 수직 집적도를 실현했다.
특히 칩과 칩 사이를 접합하는 공정에서 신호 특성이 필요한 곳은 작은 범프를, 열 방출 특성이 필요한 곳에는 큰 범프를 목적에 맞게 사이즈를 맞춰 적용했다. 크기가 다른 범프 적용을 통해 열 특성을 강화하는 동시에 수율도 극대화했다. 이와 함께 NCF로 코팅하고 칩을 접합해 범프 사이즈를 다양하게 하면서 동시에 공극 없이 적층하는 기술력도 선보였다.
삼성전자는 HBM3E 12H의 샘플을 고객사에게 제공하기 시작했으며 상반기 양산할 예정이다.
배용철 삼성전자 메모리사업부 상품기획실장 부사장은 "AI(인공지능) 서비스를 제공하는 고객사의 고용량 솔루션 니즈에 부합하는 혁신 제품 개발에 힘쓰고 있다"며 "앞으로 HBM 고단 적층을 위한 기술 개발에 주력하는 등 고용량 HBM 시장을 선도하고 개척해 나갈 것"이라고 말했다.윤선영기자 sunnyday72@dt.co.kr
Copyright © 디지털타임스. 무단전재 및 재배포 금지.
- 대학 OT서 공연 대기 여성 몰래 촬영한 학생…경찰에 붙잡혀
- "팁줄 테니 돈 빌려줘"…유흥주점 먹튀 40대의 최후
- `10대 소녀 성폭행` 가해자에 무죄 선고한 美 판사, 영구 제명됐다
- 분신했던 미군, 끝내 사망…워싱턴서 "팔레스타인에 자유" 외쳐
- "팔레스타인에 자유를" 미국 이스라엘 대사관 앞서 美 공군 분신
- 원안위, 국내 최초 원전 고리 1호기 해체 승인… 원전 해체 시장 열렸다
- "선생님, 보험 안 돼도 로봇수술로 해주세요"…수술 로봇 수입 1년 새 57% 증가
- 트럼프, 이란과 핵협상 한다면서 무력충돌 가능성도 제기
- 하반기 산업기상도 반도체·디스플레이 `맑음`, 철강·자동차 `흐림`
- `6조 돌파`는 막아라… 5대은행, 대출조이기 총력전