대만 TSMC 팹, 어디까지 가봤니? <3> [강해령의 하이엔드 테크]


정보기술(IT) 시장에 관심 많으신 독자 여러분, 안녕하세요. 지난 2주 간 강해령의 하이엔드 테크 ‘대만 TSMC 팹, 어디까지 가봤니?’에서는 TSMC의 전·후공정(패키징) 공장 위치와 기술력에 대해 살펴봤습니다. 3편에서는 TSMC 패키징에 관한 이야기를 조금 더 풀어 보려고 하는데요. 글로벌 시장 자료를 들여다보며 TSMC 패키징 영향력과 삼성전자(005930)의 사업 현황을 자세히 알아보려고 합니다. 다음 편이 마지막회입니다. 4편에서는 대만과 우리나라 후방 생태계에 관한 이야기를 종합하며 마무리해보려고 합니다. 아래 장표를 보면서 분석을 시작해보겠습니다.

자, 처음으로 보여드릴 표는 시장 조사업체 욜 디벨롭먼트가 낸 자료입니다. 패키징 기술별로 어떤 분야가 앞으로 얼마만큼 성장할 것인가를 보여주는 그래프입니다. 2021년부터 2027년까지 6년 동안 연평균 성장률이 10%가 넘어가는 분야가 두 개 보이시죠. 바로 2.5·3D와 팬아웃(FO) 분야입니다. 지난 2편을 보셨다면 상당히 익숙하실 분야죠. 서로 다른 칩을 이어 붙이거나 반도체의 두께를 기존보다 줄일 수 있는 차세대 최고급 패키징 기술입니다.
그런데 한 걸음 더 들어가보면 이 기술들은 TSMC가 주도하고 있는 영역이기도 합니다. 아래 장표로 더 자세히 살펴보겠습니다.
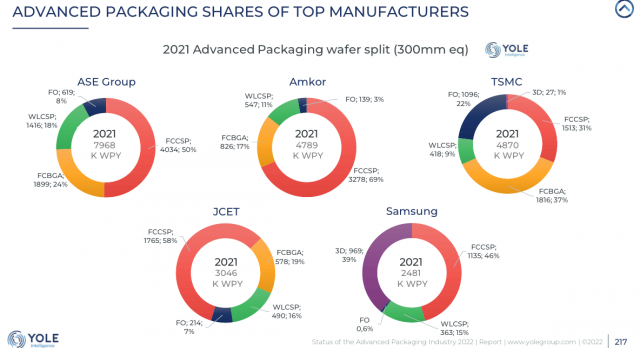
각 파운드리·패키징 회사들이 어떤 패키징 영역에 집중하고 있는가를 나타낸 장표입니다. 우측 상단 TSMC의 생산 비율을 보시죠. 다른 회사들이 가진 공통적인 특징에 비해 상당히 다르단 걸 발견할 수 있는데요. 경쟁사에 비해 남색(팬아웃·FO·22%)과 노랑색(FC-BGA·37%)의 비율이 상당히 높죠.
업계에서는 이 표에서 "이윤 많이 남는, 프리미엄 제품만 우리가 제일 잘할 것"이라는 TSMC의 의지가 잘 나타나 있다고 해석합니다. 고급 패키징 중에서도 차세대 2.5·3D 패키징을 구현할 핵심 기술인 팬아웃과 FC-BGA, 초프리미엄 패키징을 주도하겠다는 얘기입니다.
팬아웃은 개별 칩 단위로 패키징하는 것이 아니죠. 여러 칩을 둥그런 웨이퍼 모양으로 배열해서 한꺼번에 배선을 패키징(FOWLP) 하는 방법이라서요. 칩 배열만 잘하면 서로 다른 칩을 수평 결합하는 이른 바 2.5D 패키징이 상당히 용이합니다. 기판을 사용하던 기존 패키징 방법보다 칩 두께도 줄어드니 더 좋죠. TSMC는 2016년부터 애플 칩에 팬아웃을 적용한 'InFO(통합 팬아웃)'라는 브랜드로 독보적인 경쟁력을 장착하기 시작했습니다. 최근에는 InFO 기술에 칩과 칩을 아예 포개어버리는 3D 패키징 'SoIC'까지 접목해서 프리미엄 패키징 기술을 자랑하고 있죠.
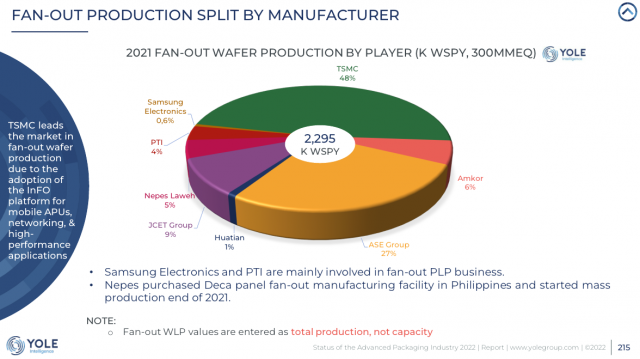
위 장표에서는 TSMC 팬아웃 장악력이 얼마나 큰지 한번 더 살펴볼 수 있습니다. 2016년 애플의 마음을 사로잡은 TSMC는 글로벌 팬아웃 생산량 중 무려 48%, 절반 가까운 점유율을 차지하고 있죠. 동그란 웨이퍼 모양이 아닌 네모난 '패널' 모양으로 팬아웃 패키징하는 일명 PLP 기술을 구현한 삼성전자와 우리나라 업체 네페스 라웨도 팬아웃 플레이어로 자리하고 있습니다. 다만 아직 점유율은 삼성전자 0.6%, 네페스 라웨 5%로 TSMC와 패키징 1위 ASE(27%) 등 대만 국가에 비하면 낮은 수준입니다.

TSMC의 플립칩-볼그리드어레이(FC-BGA) 비율이 37%인 점도 눈여겨볼 만 합니다. TSMC는 'CoWoS(칩온웨이퍼온서브스트레이트)'라는 기술로 고사양 칩용 2.5D 패키징을 구현하죠. FC-BGA라는 기판 위에 칩과 기판 사이 매개체 역할을 하는 '실리콘(Si) 인터포저'를 얹고요. 그 위에 고대역폭메모리(HBM), 시스템온칩(SoC) 등 서로 다른 칩을 얹어 일종의 칩 '마을'을 구성하는 방법입니다. 엔비디아가 TSMC FC-BGA, CoWoS를 쓰는 주요 고객사로 잘 알려져 있죠. 그래픽칩(GPU) 근처에 여러 개의 고대역폭메모리(HBM) 칩을 붙여서 GPU와 메모리 간 정보 전달을 빠르게 합니다.
덧붙이면 SK하이닉스(000660)의 주요 HBM 고객사가 엔비디아입니다. HBM을 만드는 세계 최대 메모리 회사 삼성전자, D램 3위 미국 마이크론 역시 TSMC의 3D 패키징 생태계 '3D 패브릭 얼라이언스'에 가입돼 있습니다. CoWoS 생태계가 상당히 단단하다는 방증이죠.

이러한 '이종(異種)결합' 초프리미엄 패키징으로 2021년 TSMC가 기록한 첨단 패키징 분야 생산량 점유율은 16%입니다. 패키징 업체가 아닌 파운드리 업체인데도 중국 JCET를 제치고 3위를 기록했고, 삼성전자 점유율의 2배입니다. 물론 여전히 현재의 패키징 분야 매출 점유율은 1위 ASE가 압도하고 있습니다. 단일칩 패키징 수요도 여전합니다. 하지만 미래 반도체 공정을 좌지우지할 '기술력' 하나만으로 업계의 시선이 TSMC의 행보에 쏠린다는 점이 상당히 중요한 포인트입니다.
5나노 파운드리를 1선발 투수로 두면서 어드밴스드 패키징이라는 특급 마무리 투수까지 보유한 TSMC. 앞으로도 애플·퀄컴·엔비디아·AMD 등 초대형 고객사들을 유인할 요인이 충분해 보입니다.

이제 다시 함께 살펴봐야 할 것이 장표의 삼성전자 패키징 비율입니다. 시스템 반도체 분야 시각으로 봤을 때 삼성전자는 첨단 시스템반도체용 2.5D·3D 패키징 분야에 더욱 공격적인 투자가 필요하다는 해석이 많습니다. 우선 그래프를 보시면 3D 패키징 생산량은 39%로 가장 높은데요.
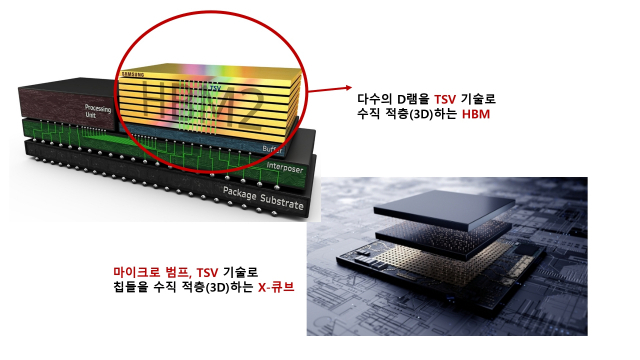
여기서 '3D'는 삼성전자의 HBM 생산 물량이 다수일 것으로 추정됩니다. HBM은 완성된 메모리 칩에 실리콘관통전극(TSV)라는 구멍을 뚫은 뒤 여러 층으로 올려 쌓는 메모리 기술입니다. 이 칩이 아까 말씀드렸던 FC-BGA 기판 위에 올라가는 것인데 차세대 메모리로 각광받습니다. 주로 삼성전자 천안 패키징 팹에서 공정이 이뤄지는 것으로 알려져 있습니다. 삼성전자는 시스템 반도체 영역에서 3D 적층은 마이크로 범프를 활용한 X-큐브라는 솔루션이 있는데요. 매출에서 이 솔루션이 어떤 성과가 있었는 지에 대해서는 공식적 언급이 없습니다.
FC-칩 스케일 패키지(CSP) 분야도 삼성전자 전체 패키징 생산량 가운데 비율이 높습니다. 다만 이 기술은 성장세가 가파른 2.5·3D 패키징보다는 단일 칩 패키징과 큰 관련이 있습니다. 주요 경쟁사의 생산 비율과 비교해봐도 차별화한 패키징 기술이라고는 보기는 조금 어렵습니다.
TSMC가 주도하는 팬아웃 비율은 PLP 사업 영위로 0.6% 정도를 차지하는데 첨단 패키징 상위 5개사 가운데 비율은 가장 낮은 편입니다. 갤럭시 워치용 칩을 PLP로 마무리하는 것으로 알려져 있습니다.

또한 삼성전자 장표에는 FC-BGA 생산량이 표시돼 있지 않습니다. 2021년에는 FC-BGA를 활용한 2.5D 생산 물량이 크지는 않아 이 통계에 따로 잡히지 않은 것으로 보입니다.
하지만 삼성전자 역시 FC-BGA를 활용한 차세대 2.5D 패키징 시장 기회를 엿보고 있습니다. 한 예로 메인 기판 아래에 보조 기판을 덧댄 'H-큐브'라는 독특한 형태의 패키징 공정을 2021년 11월에 발표했고요. 여기 쓰이는 기판은 삼성전기(009150), 패키징 세계 2위 앰코테크놀로지와 함께 개발해 주목받은 바 있습니다. H-큐브는 삼성전자 온양캠퍼스에서 생산이 이뤄지고 있다고 합니다. TSMC CoWoS와 유사한 형태의 'I-큐브'라는 브랜드도 발전시키고 있습니다.

현재 삼성전자의 패키징 캠퍼스는 온양, 천안 두 곳입니다. 온양 캠퍼스 대다수 물량은 메모리 관련 패키징 라인으로 알려졌고요. 라이벌 TSMC보다 '약간' 늦은 감이 있지만 또다른 캠퍼스인 천안 사업장은 한 개 동 내에서 어드밴스드 패키징 투자에 본격적으로 나섰습니다. 기존 PLP 라인 일부와 HBM, 올해 새롭게 꾸린 어드밴스드패키징(AVP)사업팀의 팬아웃 웨이퍼레벨(FOWLP) 팹 등으로 구성된 것으로 파악됩니다. 지난달 삼성전자는 향후 60조원 투자 발표와 함께 천안과 온양에 차세대 패키징 생산량 확충을 위한 시설 투자를 확대할 예정이라고 발표했습니다. 이재용 삼성전자 회장도 최근 이곳을 방문해 관심을 보인 만큼 향후 천안 사업장 내에 있는 삼성디스플레이 공장을 패키징 팹으로 전환하거나 아예 신규 팹을 건설하는 등 다양한 시나리오가 검토될 것으로 보입니다.
최근 TSMC 출신의 패키징 베테랑 린준청 부사장을 영입한 것도 삼성전자 패키징 기술 투자의 의지를 보여주죠. 앞으로 삼성전자가 얼마나 이 분야에 투자할지, 2.5·3D 분야에서 TSMC를 추격하기 위해 어떤 노력을 할 지 관심있게 지켜볼 대목입니다.
마지막 4편에서는 이번 시리즈에서 나왔던 내용을 다시 훑으면서 TSMC와 대만 생태계가 우리나라 시스템 반도체 업계에 시사하는 바를 정리해보고자 합니다. 감사합니다.

Copyright © 서울경제. 무단전재 및 재배포 금지.
- '399달러 애플워치 원가는 고작…' 엄청난 수익 비결 밝혀졌다
- '조용히 해' 툭하면 '이것' 보여준 아이…'발달 지연' 부른다
- 아파트 옥상서 '술파티' 벌인 10대들…'쓰레기도 안 치웠다'
- 日 은둔형 외톨이 146만명 추산…'20%는 코로나19 때문'
- 태국 길거리서 여성에게 치근덕…대사관까지 '국격 훼손 말라'
- '유튜버가 태국 현지 여성들과 선정적 방송'…후원계좌까지 띄웠다
- 영장 기각 닷새 만에 또 필로폰…남경필 장남 '구속'
- “3개월 전부터 미행”…강남 납치·살인, 금품 노린 계획 범죄
- 박원순 묘, 오늘 새벽 모란공원 이장…국힘 '피해자에 2차 가해'
- 토마토 이어 주키니까지…'드시지 말고 반품하세요'